七年以前,我撰写文章列举了成功完成BGA返工需要克服的主要挑战。随着BGA技术的不断发展,现在是时候更新这份挑战清单了。欢迎随我一起探究目前BGA返工挑战(无特定顺序)。
挑战1:超大BGA
随着器件变得更加复杂,对计算能力的要求逐渐增加,BGA封装的最大物理尺寸不断增加。目前,对于一些正在开发的器件,预计尺寸将达到125 mm x 125 mm。这些大封装尺寸对返工工艺技术人员提出了挑战。
如今,这种大型封装的贴装系统仍受限于在贴装放置过程中用于对准元器件的分割视觉棱镜系统。为了成功处理此类大型封装,BGA返工设备视觉系统需要升级。
需要升级可确保放置封装的板均匀加热的底部加热器,以处理这些大型元器件的封装尺寸。尺寸过小的底部加热源可能会导致从元器件顶部到下方区域的温度梯度不一致,从而使元器件的不同区域在不同时间达到回流。会导致元器件焊料球被拉伸或拉长;不当温度曲线导致的“冷剥离”也会损伤电路板上的BGA焊盘。
使整个元器件表面区域保持一致的温度是返工这类大型封装的另一个挑战。热风返工喷嘴中的气流湍流会使喷嘴喷出的回流温度难以保持一致,限制了其均匀回流并移除这些大封装的能力。同样,许多商用IR返工系统没有能够覆盖这类封装整个尺寸的光斑尺寸,因而无法均匀地加热元器件。
定制工装板可支撑这类更大的封装,固定在原位的模板通过焊膏印刷可打开工艺窗口,以及对正确的加热温度曲线的全面了解,都有助于使较旧的设备适应这类更大封装,尽管只是在一定程度上。
挑战2:相邻器件损伤
在返工过程中,返工区域内及周围的元器件可能会受损伤,因为通常同时使用的IR和热风热源可能会热损伤相邻部件。附近的元器件,如铝、钽和陶瓷电容器、晶体、振荡器、塑料体部件等,需要适当隔热。LED和摄像头也可能在回流温度下损坏。
如果加热区域和温度循环控制不当,这些相邻元器件不仅会因受热而损伤,还会达到回流焊温度,导致其焊料回流。在BGA返工期间,这种情况可能会导致质量较大的元器件从PCB的底部脱落。此外,当焊料回流时,焊料填充中形成的金属间化合物会生长,导致元器件与PCB形成较弱的机械连接。
使用适当的热屏蔽材料,可以避免这些问题[1]。现在可以使用更新的材料来保护元器件免受损坏和达到回流温度。如吸水性冷凝胶及陶瓷无纺布这样的热屏蔽材料是最有效的热屏蔽材料。
挑战3:底部填充BGA返工
底部填充已进入各行各业,包括汽车、军事和航空航天应用。底部填充可提高易受到机械作用和由于分布力导致冲击的元器件的可靠性。通过使用底部填充物,由于元器件和PCB之间的热膨胀系数不匹配引起的热应力也会减小。然而,底部填充的涌现增加了对底部填充元器件返工解决方案的需求。由于在未来五年中,填充的使用量每年预计增长5%以上,因此为底部填充元器件返工问题找到适当的解决方案仍然是一项挑战。
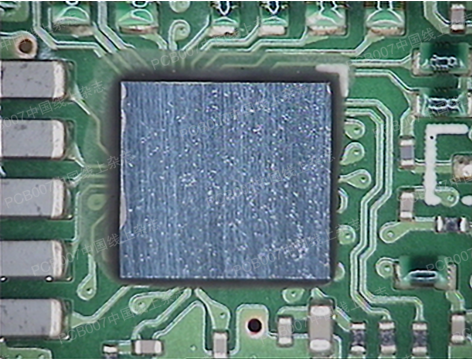
图1:底部填充BGA
在返工过程中,PCB同一面或相对面相邻的BGA返工位置可能会损伤。由于底部填充物在达到焊料的液相线温度之前软化,返工位置附近的底部填充物会将焊料从其期望位置“推出”,导致焊接异常,例如短路或其他焊接缺陷。
另一个主要的返工挑战是在元器件移除过程中从底部填充物中分离BGA。在回流期间,底部填充物的黏性将BGA紧紧地固定在PCB上。移除BGA需要返工技术人员使用刀“切割”底部填充物,或使用专门设计的喷嘴将BGA从板上拔下。这两种操作都可能导致损坏PCB焊盘或阻焊层。一旦BGA被移除,需要从PCB上手动清理底部填充材料以及残余焊料。这一人工密集型工艺对于确保在更换BGA之前充分清洁现场是必要的。
较新的方法,如使用高度控制的铣削工艺进行冷去除或对部件进行激光烧蚀,可以克服这类返工挑战。这些先进的方法虽然速度更快且可重复,但需要返工成本,且需要具备更高级的编程和处理技能。
挑战4:镜像BGA
当BGA“背靠背”放置在双面PCB的两面时,这种结构称为“镜像”(图2)。随着电路板密度的增加,这种结构会持续成为BGA返工的挑战。在BGA返工过程中,有必要从要移除和更换的BGA的另一面预热PCB。这需要在返工位置下方加热BGA,使对面BGA至少暴露在125℃温度下。此外,这会导致相对面的BGA暴露于更长时间的持续热循环,增加了损坏或翘曲BGA的可能性。还可能导致相对面元器件回流,造成焊接异常和焊点脆化。另一个危险是尺寸更大、质量更大的BGA元器件可能会从相对面位置上“脱落”,因为表面张力可能不再能够克服重力而拉下元器件。
.png)
图2:镜像BGA实例
总结
BGA返工挑战将会继续演变。大BGA封装、靠近相邻器件的BGA、底部填充BGA和镜像BGA是目前BGA返工的主要挑战。
更多内容可点击这里查看,文章发表于《PCB007中国线上杂志》23年3月号,更多精彩原创内容,欢迎关注“PCB007中文线上杂志”公众号。


